Einführung
Thermosonic Flip-Chip-Bonden ist eine fortschrittliche, lötfreie Technologie für Flächen-Array-Verbindungen. Dieser Ansatz wird verwendet, um ICs mit Goldbumps (Abbildung 1), mit vergoldeten Pads auf dem Substrat zu verbinden. Es handelt sich um einen einfachen, sauberen und trockenen Montageprozess unter Verwendung eines Bondmechanismus (Abbildung 2) ähnlich dem Thermokompressionsbonden, jedoch mit niedrigerem Bonddruck und niedrigerer Temperatur aufgrund der Zuführung von Ultraschallenenergie. Der Thermoschallprozess wurde hauptsächlich für das Drahtbonden verwendet, hat aber auch große Vorteile für Die-Attach-Anwendungen. Das reine Thermokompressionsschweißen erfordert typischerweise Flächentemperaturen in der Größenordnung von >300°C. Diese Temperatur kann Verpackungsmaterialien, Laminate und einige empfindliche Chips beschädigen. Der Thermosonic Prozess ist eine Kombination aus Thermokompressions- und Ultraschallschweißen, die jeweils die beste Qualität für die Verwendung in der Mikroelektronik optimiert. Typischerweise können die Flächentemperatur und die Bondkraft viel niedriger sein; zwischen 100 bis 160°C und 20 bis 50g/Bump, wodurch die oben erwähnten Probleme vermieden werden.
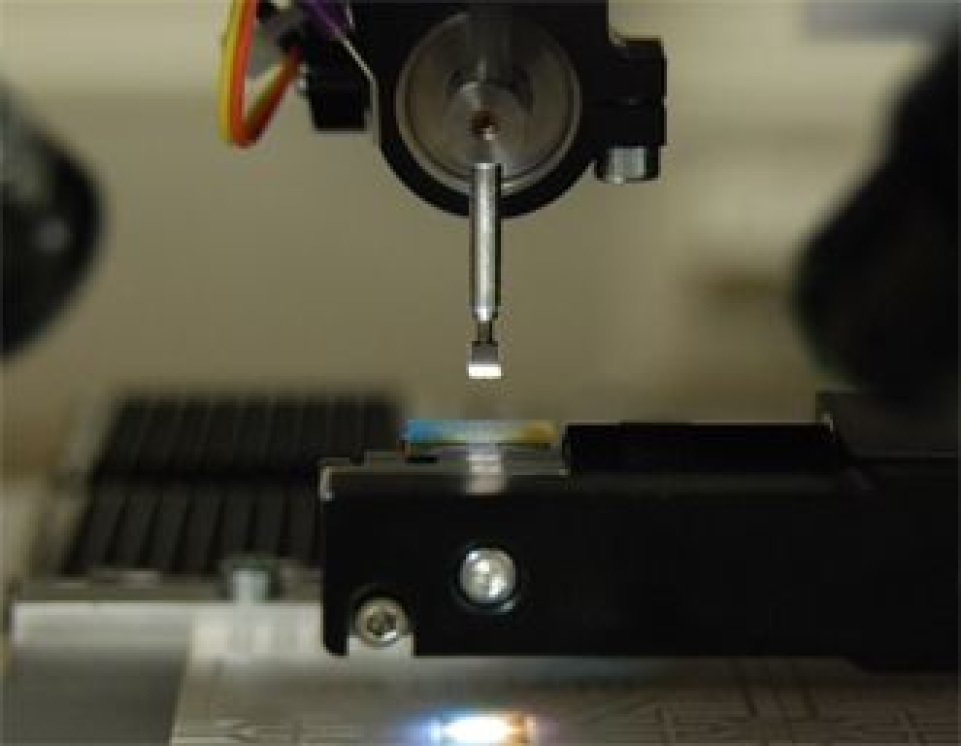
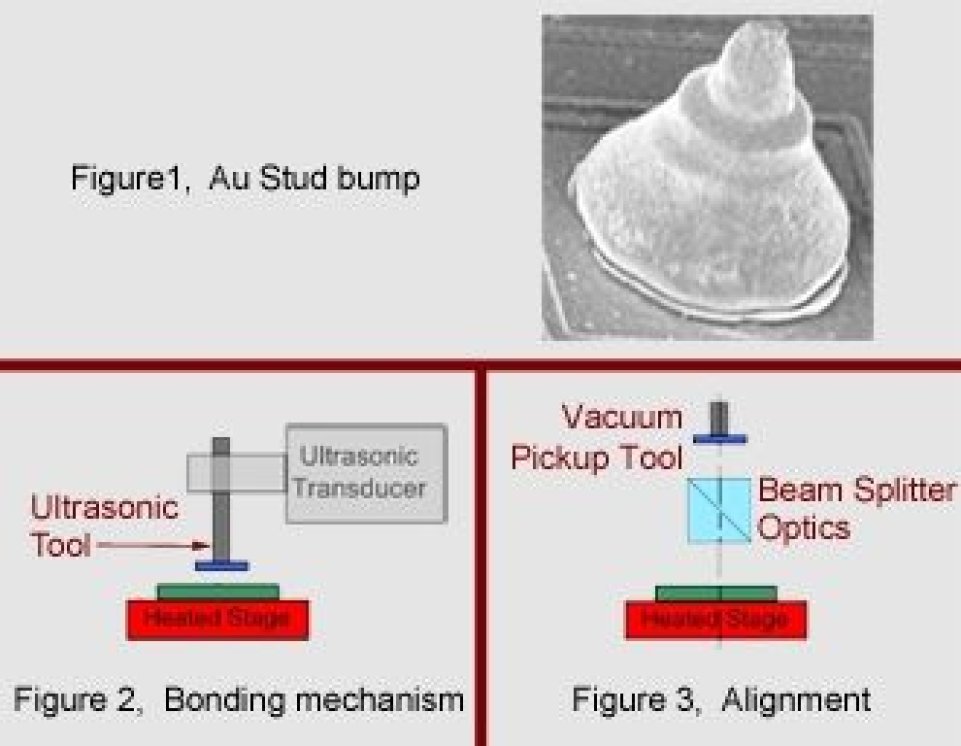
Prozess
Der Thermosonic-Prozess beginnt damit, dass das Substrat auf einem beheizten Tisch liegt und durch Vakuum in Position gehalten wird. Der Chip wird durch das Vakuum-Pickup-Werkzeug gehalten. Nach der Ausrichtung mit der Strahlteiler Optik (Abbildung 3) wird der Chip mit seinen Au-Bumps mit dem Substrat in Kontakt gebracht. Nachdem die erforderliche Bondkraft erreicht ist, wird eine Ultraschallschwingung für eine vorbestimmte Zeitdauer angewendet, um den Prozess abzuschließen.
Höchste Parallelität mit Dr. Tresky’s True Vertical Technology™
Die Parallelität des Ultraschallwerkzeugs in Bezug auf das Substrat ist ein sehr wichtiger Parameter, um ein gutes Ergebnis zu erzielen. Eine Fehlausrichtung kann zu einer ungleichmäßigen Kraftverteilung führen, die eine Verbindung auf Seite A und eine unzureichende Verbindung auf Seite B zur Folge hat (Abbildung 4). Dr. Tresky’s True Vertical Technology™ garantiert stabile und genaue Parallelität über den gesamten Z-Hub (Abbildung 5). In Kombination mit der aktiven Kraftmessung wird auf jeder Höhe ein perfektes Ergebnis erzielt (Abbildung 6).

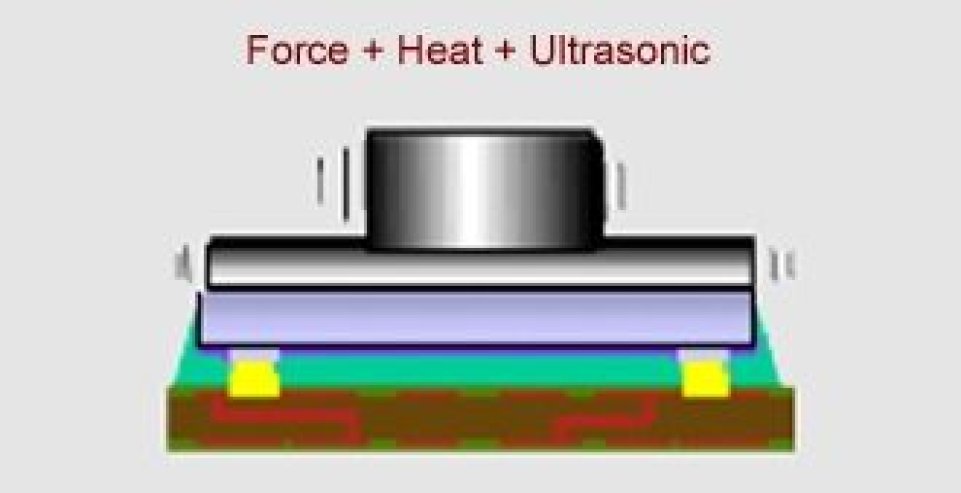
Typische Prozessparameter
Substratheizung:
100°C bis 160°C
Ultraschall-Leistung:
100 bis 200 mW/Bump
Bondkraft:
20 bis 50 g/Bump
Einfluss von Bondingparameter auf den Prozess
Kraft, Zeit, Temperatur und Ultraschallleistung sind Parameter, die einen großen Einfluss auf den Prozess haben und Systemen von Dr. Tresky individuell programmiert werden können. Generell lässt sich sagen, dass mehr Verbindungskraft, höhere Temperatur, mehr Ultraschallleistung, (höhere Amplitude der Ultraschallschwingung) und mehr Schwingungszeit zu einem grösseren Zusammenbruch der Bumps und damit höherer Festigkeit der Verbindung führen. Bei der Erhöhung dieser Parameter ist wichtig, das Risiko eines elektrischen Kurzschlusses zwischen benachbarten Bumps sowie eines möglichen Bruchs der Matrize zu erkennen (Abbildung 7-9).
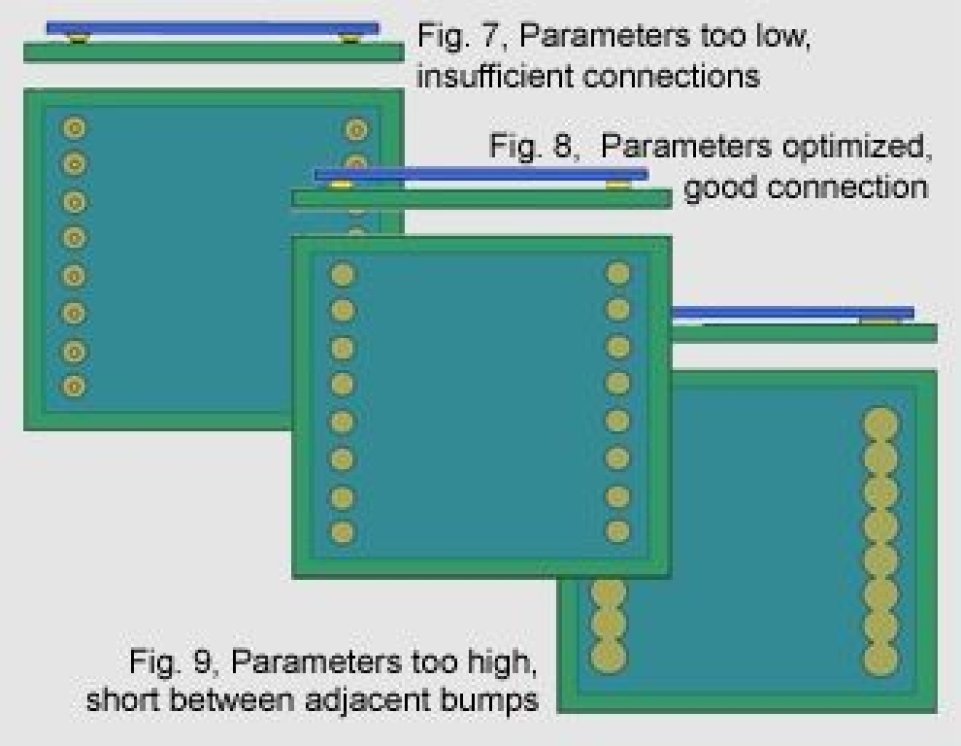
Haben Sie Fragen oder interessieren Sie sich für eine Online Produkt Demonstration?
Fabio Cocca - Ihr Sales Kontakt bei Dr. Tresky AG freut sich persönlich mit Ihnen zu sprechen. Rufen Sie ihn an oder verwenden Sie dazu das Kontaktformular.
+41 44 772 19 41
Bitte beachten Sie unsere Datenschutzerklärung.



