Generell
Die Leistungselektronik ist ein sehr schnell wachsendes Marktsegment, das vor allem durch die rasanten Fortschritte bei der Elektromobilität und den erneuerbaren Energien vorangetrieben wird. Höhere Betriebstemperaturen sind eine der Anforderungen, um eine höhere Leistungsdichte, einen höheren Wirkungsgrad und eine längere Lebensdauer bei gleichzeitiger Senkung der Herstellungskosten zu erreichen. Dies gilt insbesondere für die neueste Generation von Wide-Bandgap-Halbleitermaterialien wie SiC und GaN mit ihren hohen Schaltfrequenzen und geringen Schaltverlusten.
Das konventionelle Die-Attach-Verfahren für Leistungshalbleiter ist Weichlöten. Es hat aber mehrere Nachteile, wie z. B. die Anfälligkeit für Kriechverformung und folglich geringe Zuverlässigkeit. Zudem können Betriebstemperaturen über 250°C von Lötverbindungen nicht bewältigt werden. Die am weitesten verbreitete alternative Technologie ist das Sintern mit Verbindungsschichten auf Silber- oder Kupferbasis. Ihre Temperaturstabilität ist ausgezeichnet; gleichzeitig bietet ihre hohe elektrische und thermische Leitfähigkeit dank der sehr dünnen Grenzflächen den Vorteil besserer Kühlung und geringerer Wärmeverluste.
Silbersinterpasten können sowohl im Hochdruck- als auch im Niederdruck-Sinterverfahren aufgebracht werden und lassen sich auf TRESKY Die-Bonding-Anlagen ähnlich wie herkömmliche Lotpasten verarbeiten. Darüber hinaus können auch Die Transfer Films in unseren Anlagen eingesetzt werden.
Es gibt eine Vielzahl von Verfahren für verschiedene Sintermaterialkombinationen, die im Laufe der Jahre auf TRESKY Die-Bonding-Anlagen entwickelt wurden.
Herunterladen

Niederdruck-Sinterpasten
Für Niederdruck- oder drucklose Sinterpasten wird häufig ein zweistufiger Prozess eingesetzt. Dabei wird zunächst die Paste durch einen Dosier- oder Siebdruckschritt auf das Substrat aufgetragen. Der Die-Bonder Modell T-5300 nimmt dann den Die entweder aus einem Waffel- oder Gel-Pack oder direkt von einem Wafer auf und legt ihn mit einer definierten geringen Kraft in das Sinterpastenbett, während das Bondwerkzeug für kurze Zeit auf eine programmierte Temperatur von etwa 200°C erhitzt wird, um den Die mit dem Substrat zu verbinden. Im zweiten Schritt, der sehr viel länger dauern kann, werden die Teile in einem Ofen mit einem definierten Temperaturprofil ausgehärtet, und die mikroskopisch kleinen Metallpartikel schmelzen in einem kontrollierten Diffusionsprozess aneinander, wodurch eine starke und dauerhafte Verbindung entsteht.
Wenn die Zykluszeit nicht kritisch ist, kann der Prozess vereinfacht werden und vollständig im Die Bonder ablaufen. Zusätzlich zum beheizten Bondwerkzeug kann auch der Substrathalter mit programmierbaren Temperaturprofilen beheizt werden, um eine hervorragende Prozessstabilität zu gewährleisten
Hochdruck-Sinterpasten
Das alternative Verfahren arbeitet mit hohem Druck und wird in der Regel in einem einzigen Schritt und bei kürzeren Zykluszeiten ausgeführt. Es verwendet Hochdruck-Sinterpasten, bei denen der gesamte Prozess im Die-Bonder stattfindet. Hier werden höhere Drücke von 10 MPa und mehr bei typischen Temperaturen von 230°C für mehrere Minuten verlangt. Der Die-Bonder kann programmierbare Kräfte von bis zu 100N beim T-5300 bzw. 500N beim T-3000-PRO aufbringen, die den erforderlichen Druck für Chipgrößen bis zu etwa 7x7 mm^2 liefern. Höhere Temperaturen von bis zu 400°C sind ebenfalls für verschiedene Sinterpasten möglich, und zwar mit programmierbaren Temperaturprofilen sowohl im Bondwerkzeug als auch im Substrathalter.
Eine in jüngerer Zeit entwickelte Technologie verwendet Die Transfer Films anstelle von Sinterpasten. Sie können von unseren Die-Bondern ähnlich wie das Flux-Dipping von Dies gehandhabt werden. Der Die wird zunächst auf einen Die-Transfer-Film-Preform in der richtigen Größe abgelegt. Die Folie wird dann zusammen mit dem Die von ihrem Träger abgezogen, bevor sie auf dem Substrat platziert wird, wiederum mit programmierbarer Kraft und Temperatur, um sie in der Position zu fixieren.
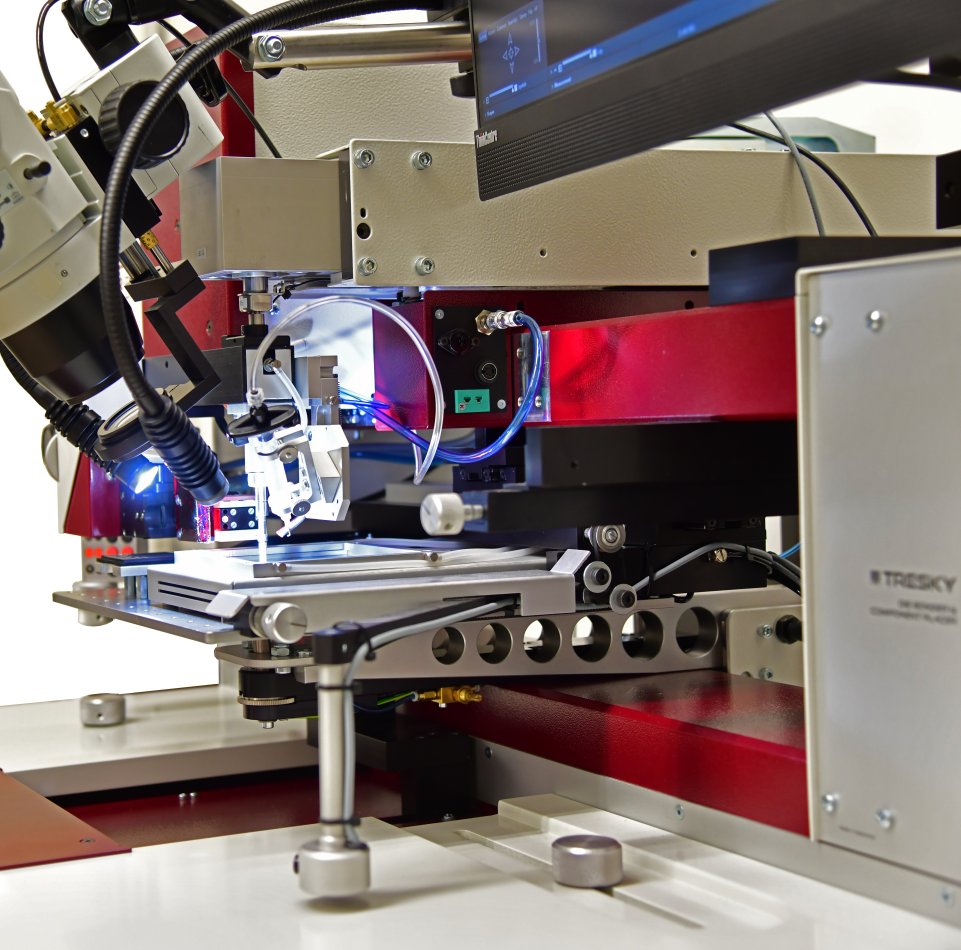
Andere Sintersysteme
Es gibt noch weitere Einsatzmöglichkeiten für gesinterte Oberflächen auf der Oberseite des Halbleiterchips, nicht nur auf der Unterseite. Halbleiter, die bei höheren Temperaturen arbeiten, werden vorzugsweise mit Kupferdrähten kontaktiert, da die üblichen Aluminiumdrähte bei den gewünschten Betriebstemperaturen eine wesentlich geringere Zuverlässigkeit aufweisen. Der Hauptnachteil von Kupferdrähten besteht jedoch darin, dass sie viel härter als Aluminium sind und die Chipoberfläche beim Drahtbonden einer viel höheren mechanischen Belastung ausgesetzt ist, was wiederum zu einer geringeren Zuverlässigkeit führt. Ein neu entwickelter, attraktiver Ausweg ist eine mechanische Bondpufferschicht aus Kupfer mit einer aufgebrachten Silbersinterschicht. Diese wird vom Die-Bonder als zusätzliche Lage auf den Die aufgebracht und gleichzeitig mit dem Die im selben Prozess auf das Substrat gesintert.
Haben Sie Fragen oder interessieren Sie sich für eine Online Produkt Demonstration?
Fabio Cocca - Ihr Sales Kontakt bei Dr. Tresky AG freut sich persönlich mit Ihnen zu sprechen. Rufen Sie ihn an oder verwenden Sie dazu das Kontaktformular.
+41 44 772 19 41
Bitte beachten Sie unsere Datenschutzerklärung.



